D 型 GaN HEMT 在功率转换方面的优势
氮化镓 (GaN) 是一种 III-V 族宽带隙半导体,由于在用作横向高电子迁移率晶体管 (HEMT) 时具有卓越的材料和器件性能,因此在功率转换应用中得到越来越多的采用。
HEMT 中产生的高击穿电场 (3.3 MV/cm) 和高二维电子气 (2DEG) 载流子迁移率 (2,000 cm 2 / Vs) 可实现低比导通电阻 (R DS(on) )。这反过来又使得更小的器件具有更低的电容,从而降低损耗和/或更高的开关频率,这可以带来系统成本、尺寸和效率优势。在本文中,我们将讨论常见的 GaN HEMT 器件使用选项,并重点介绍在高功率转换应用中使用耗尽型(d 型)HEMT 的一些优势。
GaN HEMT 类型
如图 1 所示,GaN HEMT 由放置在 GaN 沟道层上方的氮化铝镓 (AlGaN) 异质结形成。异质结中的极化效应自然会诱导通道中二维电子气的形成。该器件本质上是在栅极上施加零电压的情况下开启的,因此称为“耗尽模式”。在电力电子器件中,为了安全性和更简单的系统设计,开关器件优选为常断增强模式(e-mode)器件。
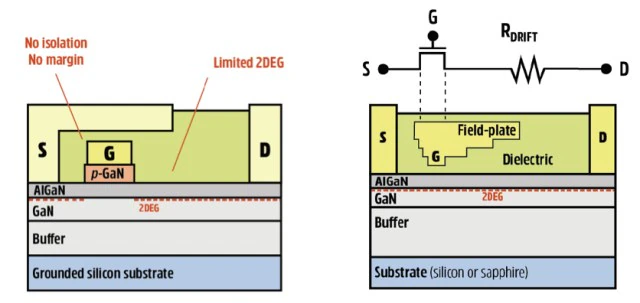
图 1:p-GaN 栅极 e 模式和 d 模式 GaN HEMT 器件的简化横截面图(Transphorm)人们尝试了不同的方法,通过对栅极内部或周围进行修改,将 d 模式器件转换为 e 模式。许多公司采用的方法是在栅极金属和 AlGaN 层之间添加 p-GaN 层(如图 2 所示)。这会将导带提升到费米能级之上,并使器件进入 e 模式,阈值电压 (V t ) 通常在 1.4 至 1.7 V 范围内。这里,可以根据栅极金属接触的类型进行细分,如图2所示。肖特基接触可以降低栅极导通时的栅极电流(I gs )并提高栅极电压(V gs)操作范围稍小,但在可靠性方面存在潜在缺点,这一点将在稍后讨论。

图 2:使用 p-GaN e 模式 GaN HEMT 形成栅极金属的选项(Borghese 等人,2021 1)d 模式器件可以与低压硅 (LV Si) MOSFET 器件级联,如图 3 所示。这允许更高的有效 V t (>2.5 V) 开启,从而允许使用栅极传统硅电力电子设备中的驱动器。
与 d 模式 GaN HEMT 一起使用的共源共栅配置。
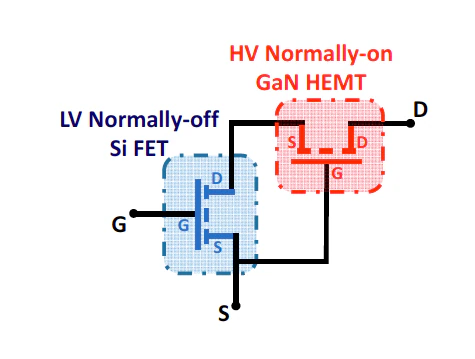
图 3:与 d 模式 GaN HEMT 一起使用的共源共栅配置(Roccaforte 等人,2019 2)关于 HEMT 驱动机制的上述类别中存在多个子变体,并在表 1 中突出显示。
GaN HEMT 基于其技术和驱动机制的变化的一些示例。
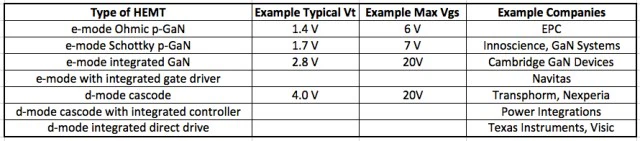
表 1:基于技术和驱动机制的 GaN HEMT 变化的一些示例现在,我们将重点关注功率转换应用中共源共栅 d 模式方法与 e 模式方法相比的一些关键优势。其中一些在GaN 共源共栅器件制造商Transphorm 发布的白皮书中进行了总结。
共源共栅 D 模式 GaN HEMT 优势
降低 R DS(on)。多种因素可能导致 e 模式器件的品质因数比共源共栅器件差:
e-mode 器件中的 2DEG 电荷密度通常需要降低才能达到一定的 V t。如图 4 所示,这会导致更高的 2DEG 方块电阻。
e-mode 器件的栅极电压范围 (V gs-max ) 较低,可能导致沟道无法实现完全反转。共源共栅架构控制 LV Si MOSFET 的开启,该 MOSFET 通常可驱动至高 (20V) V gs , d 模式 GaN 上的V gs接近 0V,从而保持器件完全开启。
e 模式器件中R DS(on)的温度系数较高。造成这种情况的一个重要因素是 p-GaN e 模式器件的跨导随温度的变化而大幅降低,如图 5 所示。在共源共栅结构中,LV Si CMOS 器件对器件跨导特性有更好的控制,并且没有表现出相同水平的温度依赖性。在与 e-mode 器件的正面比较中,共源共栅结构的外壳温度降低了 50%,功率转换效率提高了。

图 4: d 模式和 e 模式 GaN HEMT 器件中AV t与通道 2DEG 薄层电阻的关系(Transphorm)p-GaN 栅极 e 模式和共源共栅 d 模式 GaN HEMT 器件之间的跨导温度响应比较。
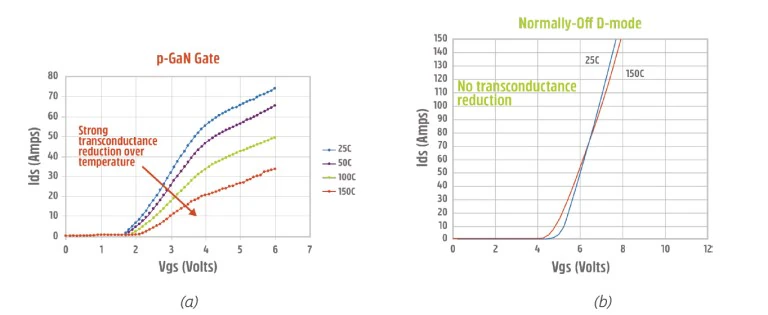
图 5:p-GaN 栅极 e 模式和共源共栅 d 模式 GaN HEMT 器件之间的跨导温度响应比较(Transphorm)动态 R DS(on)。p-GaN 栅极器件的肖特基势垒变体可能会产生动态阈值问题,因为它会在导通转换期间阻碍栅漏电容 (C gd ) 的放电。3这进而可能导致动态 R DS(on)问题。在漏极电压为 480 V 时,p-GaN 肖特基栅极增强型 GaN HEMT 的动态 R DS(on)增加了 27%,而共源共栅器件的动态 R DS(on) 增加了 5%。这会导致增强模式器件中产生更大的传导损耗,如图 6 所示。C gd放电困难导致的V t不稳定也会导致增强模式器件中更大的开关损耗。
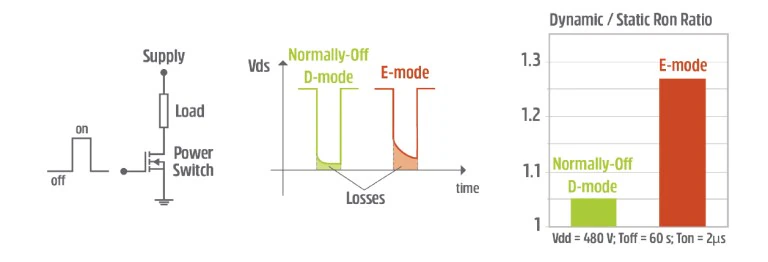
p-GaN 栅极 e 模式和共源共栅 d 模式 GaN HEMT 器件的动态 RDS(on) 性能和传导损耗比较。
图 6: p-GaN 栅极 e 模式和共源共栅 d 模式 GaN HEMT 器件之间的动态 R DS(on)性能和传导损耗比较(Transphorm)负栅极驱动要求。e 模式器件的低 Vt可能需要在关断时使用负Vgs 。这会增加栅极驱动电路的复杂性并增加死区时间损失。在反向源漏导通模式下,电流必须克服负栅极驱动,从而导致损耗增加。
可靠性。肖特基二极管p-GaN 栅极增强模式器件充当背靠背二极管(见图 2)。实际上,这可能会在栅极过压条件下产生可靠性问题。在强正 V gs下,肖特基二极管反向偏置,导致V gs > V t落在金属界面附近的 p-GaN 耗尽层上。高电场会产生渗透路径和泄漏。器件的与时间相关的故障也可能是由于电子从沟道注入 p-GaN 导致雪崩,或者是由于 p-GaN/AlGaN 界面中的陷阱产生。p-GaN 侧壁的粗糙度也会增加泄漏。在高 V gs下从金属注入 p-GaN 层的空穴会在 p-GaN/AlGaN 界面处积聚并导致器件 V t降低。4 V ds限制:增强型器件的 Si 衬底必须连接到源极端子,以减轻由源极注入电子引起的缓冲层充电。这会将器件的漏源电压额定值限制为约 650 V,因为电压较高时需要更厚的缓冲器。共源共栅器件已在更高的额定电压和双向开关中得到验证。5随着增强型模式器件与安全和感测电路的进一步集成,栅极驱动器本身可能使增强型模式器件的应用更加稳健。然而,固有的 d 型 GaN HEMT 优势使其能够与目前由碳化硅技术更容易主导的更高功率电压领域竞争。Transphorm在其 d 模式 GaN 共源共栅技术上展示了高性能和强大的功率转换,该技术采用标准封装,可以用标准栅极驱动器驱动。




